AI芯潮下,誰能破解芯片封測的“隱形難題”?
指尖輕點手機屏幕,AI算法瞬間推送精準適配的短視頻;一句語音指令,AI音箱便快速檢索天氣、播報資訊,甚至聯動智能家居完成場景控制;自動駕駛汽車依托車載芯片的實時算力,精準識別路況、規避風險,實現自主導航與行駛——我們每天沉浸式享受的智能科技,背后都離不開一顆高效運轉的芯片,而很少有人知曉,每一顆芯片從晶圓到成品,都必須闖過最后一道關鍵“關卡”:封測。



數據來源:Yole、中商產業研究院整理
不少封測企業為了承接AI芯片訂單,不惜重金升級先進封裝設備,單塊晶圓的投入就超過百萬元。晶圓制造良率能達到行業領先的99%以上,可進入封測環節后,良率卻驟降至80%以下。更棘手的是,由于彈片精度不足,0.5μm的微小偏差就可能導致整顆芯片失效;在高溫測試場景下,彈片易出現應力松弛、性能衰減等問題,前期投入付諸東流,還要面臨客戶的退貨索賠。訂單排期已排至兩年后,卻因彈片問題不敢接新單,眼睜睜看著商機溜走。
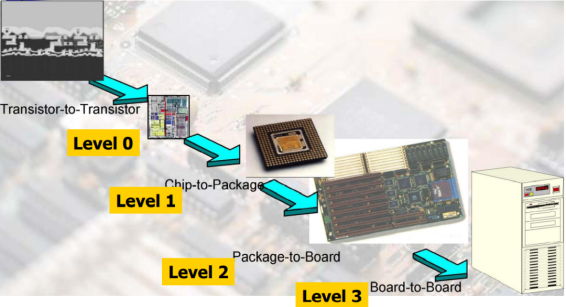
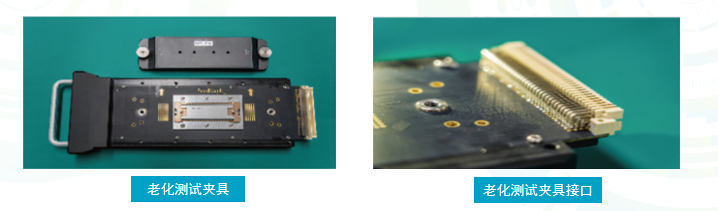
在這樣的行業困境下,并非沒有破局者。深耕精密彈片領域十余年的老化測試彈片廠家——東莞市禾聚精密電子科技有限公司,早已洞察到封測企業的核心焦慮。作為一家專業生產芯片封測彈片的制造商,禾聚精密的芯片封測彈片,規格齊全,使用壽命長,精準匹配AI時代先進封裝的高要求,完美規避了行業普遍存在的精度不足、性能不穩定、交付滯后等痛點,用扎實的實力,成為封測企業突破瓶頸、抓住AI風口的底氣。
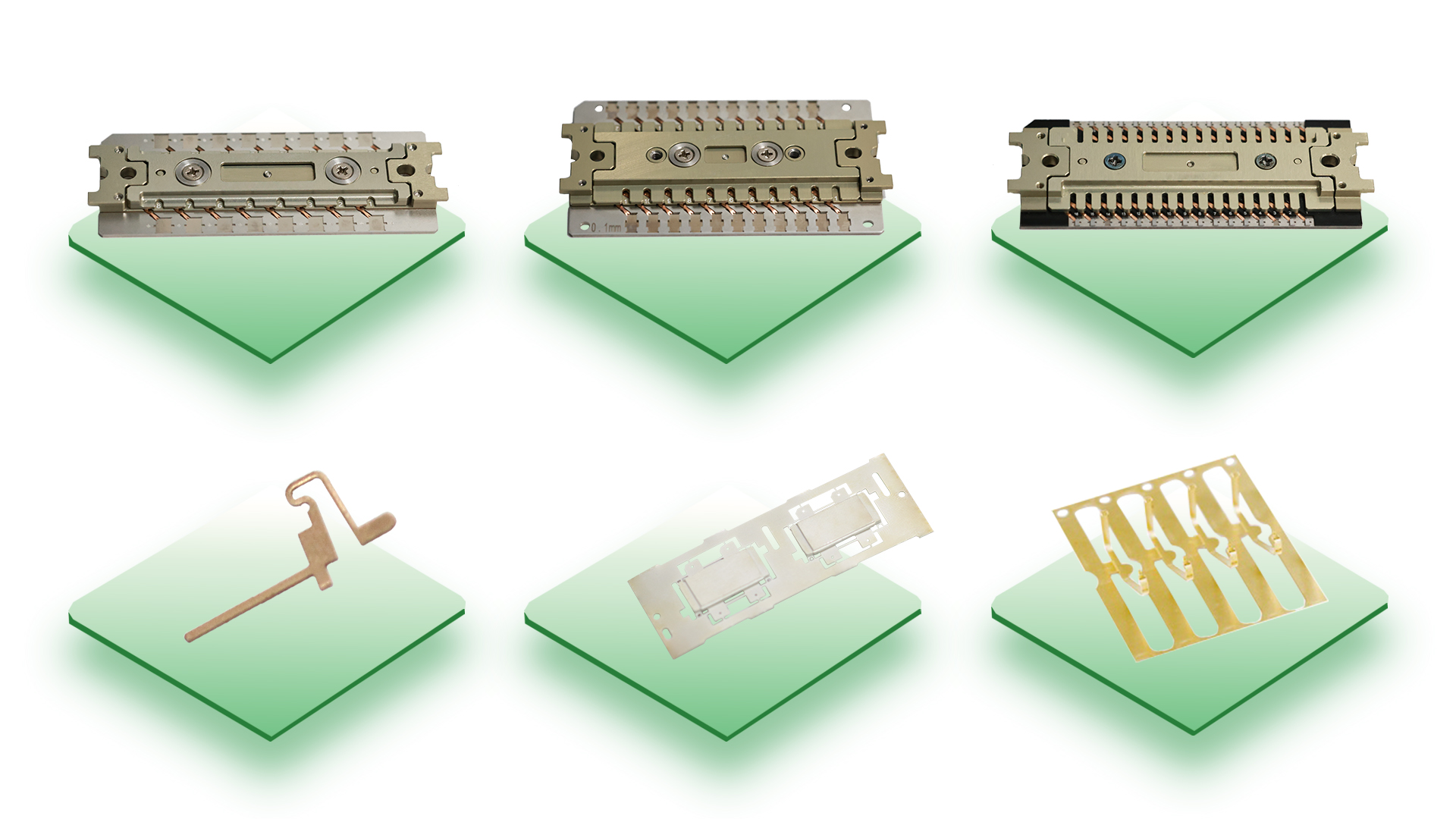
下一篇:已經是最后一篇了
上一篇:電池防爆閥選型 “避坑指南”
 中文
中文 English
English








